1. J. J. Soh, D. S. Shim, and W. B. Byung, Technical trend of Restriction of Hazardous Substances Directive (RoHS), Conference of The Korean Institute of Electrical En- gineering. (2009) 1289ŌĆō1290.
2. J. Glazer, Microstructure and Mechanical Properties of Pb-Free Solder Alloys for Low-Cost Electronic Assembly, A Review,
J. Electron. Mater. (1994) 23(8) 693ŌĆō700. https://doi.org/10.1007/BF02651361
[CROSSREF] [PDF] 3. S.W. Kim, J.W.. Yoon, and S.B. Jung, Interfacial Reactions and Shear Strengths between Sn-Ag-based Pb-Free Solder Balls and Au/EN/Cu metallization,
J. Electron. Mater. (2004) 33(10) 1182ŌĆō1189. https://doi.org/10.1007/s11664-004-0121-y
[CROSSREF] [PDF] 4. A. Lee, S. Jo, J. Park, and C. Kang, Improvement of Solder Joint Strength in SAC 305 Solder Ball to ENIG Substrate Using LF Hydrogen Radical Treatment,
J. Korean Weld. Join. Soc. (2011) 29(1) 99ŌĆō106. https://doi.org/10.5781/KWJS.2011.29.1.099
[CROSSREF] 5. B. Noh, J. Lee, and S. Jung, Characteristic of Underfill with Various Epoxy Resin, J. Microelectronic &Packag. Soc. (2006) 13(3) 39ŌĆō45.
6. P. Borgesen, D. Blass, and M. Meilunas, Effects of Corner/Edge Bonding and Underfill Properties on the Thermal Cycling Performance of Lead Free Ball Grid Array Assemblies,
J. Electron. Packag. (2012) 134(1) 011010-1-011010-8https://doi.org/10.1115/1.4005904
[CROSSREF] [PDF] 7. F. Liu, Y. P. Wang, K. Chai, and T. D. Her, Characterization of molded underfill material for flip chip ball grid array packages,
51st Electronic Components and Technology Conference (IEEE). (2001) 288ŌĆō292. https://doi.org/10.1109/ECTC.2001.927737
[CROSSREF] 8. B. Noh, B. Lee, S. Kim, and S. Jung, Evaluation of Thermal Property and Fluidity with Underfill for BGA Package, J. Korean. Weld. Join. Soc. 24(2) (2006) 165ŌĆō171.
9. U. Scheuermann, Reliability challenges of automotive power electronics,
Microelectron. Rel. 49(9-11) (2009) 1319ŌĆō1325. https://doi.org/10.1016/j.microrel.2009.06.045
[CROSSREF] 10. J. H. Bang, D. Y. Yu, Y. H. Ko, J. W. Yoon, and C. W. Lee, Lead-free Solder for Automotive Electronics and Reliability Evaluation of Solder Joint,
J. Weld. Join. 34(1) (2016) 26ŌĆō34. https://doi.org/10.5781/JWJ.2016.34.1.26
[CROSSREF] [PDF] 11. Y. Yamada, Y. Takaku, Y. Yagi, I. Nakagawa, T. Atsumi, M. Shirai, I. Ohnuma, and K. Ishida, Reliaibility of wirebonding and solder joint for high temperature operation of power semiconductor device,
Microelec- tron. Reliab. 47(12) (2007) 2147ŌĆō2151. https://doi.org/10.1016/j.microrel.2007.07.102
[CROSSREF] 12. B. Ji, V. Pickert, W. Cao, and B. Zahawi, In situ diagnostics and prognostics of wire bonding faults in IGBT modules for electric vehicle drives,
IEEE Trans. Power Electron. 28(12) (2013) 5568ŌĆō5577. https://doi.org/10.1109/TPEL.2013.2251358
[CROSSREF] 13. J. Biela, M. Schweizer, S. Waffler, W. Johann, and . Kolar, SiC versus Si-Evaluation of Potentials for Performance Improvement of Inverter and DC-DC Converter Systems by SiC Power Semiconductors,
IEEE Trans. Industrial Electron. 58(7) (2011) 2872ŌĆō2882. https://doi.org/10.1109/TIE.2010.2072896
[CROSSREF] 14. H. S. Choi, Overview of silicon carbide power devices, Fairchild semiconductor. (2016)
15. W. M. Choi and H. G. Ahn, The Switching Characteristic and Efficiency of New Generation SiC MOSFET,
J. Korea Inst. Inf. Commun. Eng. 21(2) (2017) 353ŌĆō360. http://doi.org/10.6109/jkiice.2017.21.2.353
[CROSSREF] [PDF] 16. Z. Zhang and C.P. Wong, Recent advances in flip-chip underfill, materials, process, and reliability,
Trans IEEE Adv. packag. 27(3) 515ŌĆō524. https://doi.org/10.1109/TADVP.2004.831870
[CROSSREF] 17. M. Ying, A. Tengh, Y.C. Chia, A. Mohtar, and P.W.. Wong, Process Development of Void Free Underfilling for Flip-chip-on-board,
2007 9th Electronics Packaging Technology Conference. (2007) 805ŌĆō810. https://doi.org/10.1109/EPTC.2007.4469688
[CROSSREF] 18. P. Liu, C. Lin, B. Pathangey, and D. Goyal, The mechanism of dense interfacial voids and its impact on solder joint reliability,
2016 IEEE 66th Electronic Components and Technology Conference (ECTC). (2016) 1128ŌĆō113. https://doi.org/10.1109/ECTC.2016.104
[CROSSREF] 19. J. Wojewoda-Budka, Z. Huber, L. Litynska-Dobrzynska, N. Sobczak, and P. Zieba, Microstructure and chemistry of the SAC/ENIG interconnections,
Mater. Chem. Phys. 139(1) (2013) 276ŌĆō280. https://doi.org/10.1016/j.matchemphys.2013.01.035
[CROSSREF] 20. C.F. Tseng and J.G. Duh, Correlation between microstructure evolution and mechanical strength in the Sn-3.0 Ag-0.5 Cu/ENEPIG solder joint,
Mater. Sci. Eng. A. (2013) 580 169ŌĆō174. https://doi.org/10.1016/j.msea.2013.05.058
[CROSSREF] 21. B. Noh, J. Yoon, and S. Jung, Effects of underfill materials and thermal cycling on mechanical reliability of chip scale package,
IEEE Trans. Compon. Packag. Technol. 32(3) (2009) 633ŌĆō638. https://doi.org/10.1109/TCAPT.2008.2010503
[CROSSREF] 22. H. McCormick, P. Snugovsky, C. Hamilton, Z. Bagheri, and S. Bagheri, The great SAC debate:comparing the reliability of SAC305 and SAC405 solders in a variety of applications, SMTA Pan Pacific Symposium. (2007)
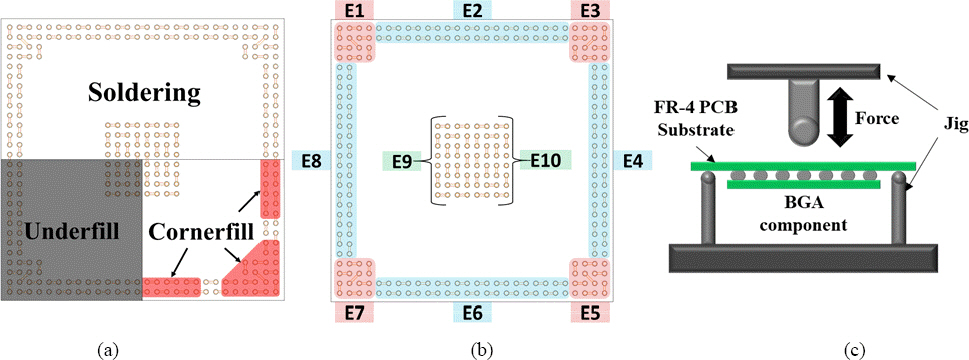
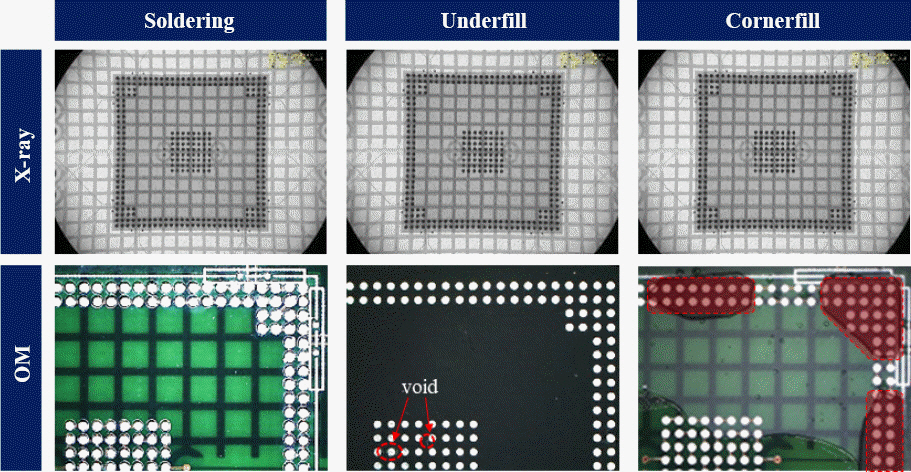

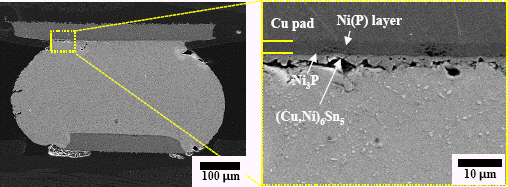




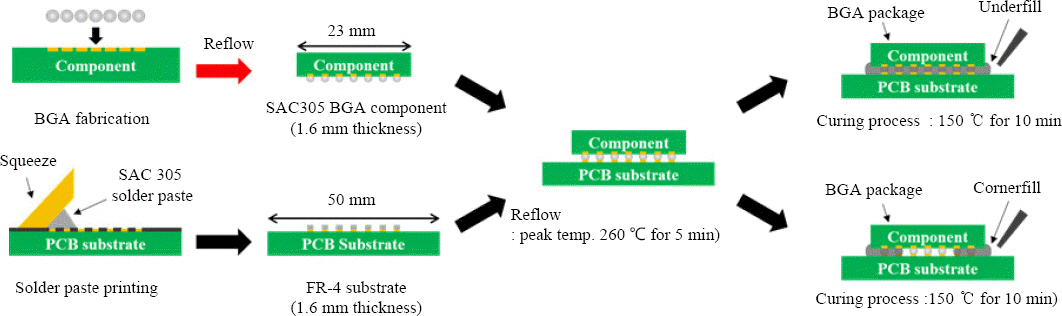

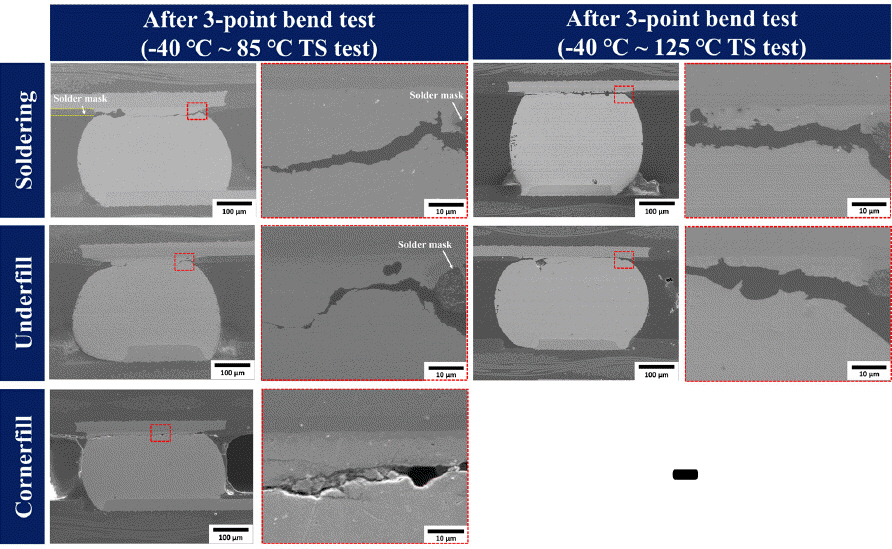
 PDF Links
PDF Links PubReader
PubReader ePub Link
ePub Link Full text via DOI
Full text via DOI Download Citation
Download Citation Print
Print



