1. Ūô©žąė. ž†Ą and žĚľžĄĚ. žĖĎ, ž†ĄŽ†•ŽįėŽŹĄž≤ī žčúžě• ŽįŹ Íłįžą†ÍįúŽįú ŽŹôŪĖ•, ž†ĄžěźŪÜĶžč†ŽŹôŪĖ•Ž∂ĄžĄĚ. 28(6) (2013) 206‚Äď216.
2. J. W. Yoon, J. H. Bang, Y. H. Ko, S. H. Yoo, J. K. Kim, and C. W. Lee, Power module packaging technology with extended reliability for electric vehicle applications,
J. Microelectron. Packag. Soc. 21(4) (2014) 1‚Äď13.
https://doi.org/10.6117/kmeps.2014.21.4.001
[CROSSREF] 3. H. Choi, Overview of Silicon Carbide Power Devices, Fairchild Semiconductor. (2016)
7. A. Kroupa, D. Andersson, N. Hoo, J. Pearce, A. Watson, A. Dinsdale, and S. Mucklejohn, Current problems and possible solutions in high-temperature lead-free soldering,
J. Mater. Eng. Perform. 21(5) (2012) 629‚Äď637.
https://doi.org/10.1007/s11665-012-0125-3
[CROSSREF] 8. N. C. Lee, Lead-free soldering-where the world is going, Society of Manufacturing Engineers. (2000)
11. T. Zhou, T. Bobal, M. Oud, and J. Songliang, Au/Sn solder alloy and its applications in electronics packaging, Coining inc. (1999)
12. R. R. Chromik, D N. Wang, A. Shugar, L. Limata, M. R. Notis, and R. P. Vinci, Mechanical properties of intermetallic compounds in the Au-Sn system,
J. Mater. Res. 20(8) (2005) 2161‚Äď2172.
https://doi.org/10.1557/JMR.2005.0269
[CROSSREF] 14. F. Yu, J. Cui, Z. Zhou, K. Fang, R. W. Johnson, and M. C. Hamilton, Reliability of Ag sintering for power semiconductor die attach in high-temperature applications,
IEEE Trans. Power Electron. 32(9) (2016) 7083‚Äď7095.
https://doi.org/10.1109/TPEL.2016.2631128
[CROSSREF] 15. E. J. Jang, S. M. Hyun, and H. J. Lee, and Y. B. Park, Effect of wet pretreatment on interfacial adhesion energy of Cu-Cu thermocompression bond for 3D IC packages,
J. Electron. Mater. 38(12) (2009) 2449‚Äď2454.
https://doi.org/10.1007/s11664-009-0942-9
[CROSSREF] 16. W. Yang, H. Shintani, M. Akaike, and T. Suga, Low temperature Cu-Cu direct bonding using formic acid vapor pretreatment,
2011 IEEE 61st Electronic Components and Technology Conference (ECTC). (2011) 2079‚Äď2083.
https://doi.org/10.1109/ECTC.2011.5898804
[CROSSREF] 17. J. F. Lynch, L. Feinstein, and R. A. Huggins, Brazing by the Diffusion-Controlled Formation of a Liquid Intermediate Phase, Weld. J. 38(2) (1959) 85‚Äď89.
18. D. Paulonis, D. S. Duvall, and W. A. Owczarski, Diffusion bonding utilizing transient liquid phase, US Patent US3678570 A, (1972)
20. H. Feng, J. Huang, J. Zhang, X. Zhai, X. Zaho, and S. Chen, High temperature resistant Ni-Sn Transient liquid phase sintering bonding for new generation semiconductor power electronic devices,
2015 IEEE 17th Electronics Packaging and Technology Conference (EPTC). (2015) 1‚Äď4.
https://doi.org/10.1109/EPTC.2015.7412388
[CROSSREF] 23. K. H. Jung, K. D. Min, C. J. Lee, and S. B. Jung, Pressureless die attach by transient liquid phase sintering of Cu nanoparticles and Sn-58Bi particles assisted by polyvinylpyrrolidone dispersant,
J. Alloys Compd. 781 (2019) 657‚Äď663.
https://doi.org/10.1016/j.jallcom.2018.12.032
[CROSSREF] 32. Z.L. Li, H.J. Dong, X.G. Song, H.Y. Zhao, J.C. Feng, J.H. Liu, H. Tian, and S.J. Wang, Rapid formation of Ni
3Sn
4 joints for die attachment of SiC-based high temperature power devices using ultrasound-induced transient liquid phase bonding process,
Ultrason. Sonochem. 36 (2017) 420‚Äď426.
https://doi.org/10.1016/j.ultsonch.2016.12.026
[CROSSREF] [PUBMED] 34. B. Kuhn, F. J. Wetzel, J. Malzbender, R. W. Steinbrech, and L. Singheiser, Mechanical performance of reactive-air-brazed (RAB) ceramic/metal joints for solid oxide fuel cells at ambient temperature,
J. Power Sources. 193(1) (2009) 199‚Äď202.
https://doi.org/10.1016/j.jpowsour.2008.10.117
[CROSSREF] 35. J. Cao, M. Zheng, Z. Wang, X. Si, C. Li, X. Wang, Z. He, and J. Qi, A low-temperature sealing method for metal-supported oxide fuel cell applications:Ni-Sn transient liquid phase bonding,
Vacuum. 187 (2021) 110048
https://doi.org/10.1016/j.vacuum.2021.110048
[CROSSREF] 39. S. Baek, G.W. Jeong, J. H. Son, M. S. Kim, H. B. R. Lee, J. Kim, and Y. H. Ko, Interfacial reactions and mechanical properties of transient liquid-phase bonding joints in Cu/Sn/Ni (P) and Ni/Sn/(OSP) Cu structures for power modules,
J. Mater. Sci. Mater. Electron. 32(3) (2021) 3324‚Äď3333.
https://doi.org/10.1007/s10854-020-05080-1
[CROSSREF] 40. H. Y. Zhao, J. H. Liu, Z. L. Li, Y. X. Zhao, H. W. Niu, X. G. Song, and H. J. Dong, Non-interfacial growth of Cu
3Sn in Cu/Sn/Cu joints during ultrasonic-assisted transient liquid phase soldering process,
Mater. Lett. 186 (2017) 283‚Äď288.
https://doi.org/10.1016/j.matlet.2016.10.017
[CROSSREF] 43. J. H. Liu, H. Y. Zhao, Z. L. Li, X. G. Song, H. J. Dong, Y. X. Zhao, and J. C. Feng, Study on the microstructure and mechanical properties of Cu-Sn intermetallic joints rapidly formed by ultrasonic-assisted transient liquid phase soldering,
J. Alloys Compd. 692 (2017) 552‚Äď557.
https://doi.org/10.1016/j.jallcom.2016.08.263
[CROSSREF] 45. H. Ji, M. Li, S. Ma, and M. Li, Ni
3Sn
4-composed die bonded interface rapidly formed by ultrasonic-assisted soldering of Sn/Ni solder paste for high-temperature power device packaging,
Mater. Des. 108 (2016) 590‚Äď596.
https://doi.org/10.1016/j.matdes.2016.07.027
[CROSSREF] 46. W. Zhang, Y. Cao, J. Huang, W. Zhao, X. Liu, M. Li, and H. Ji, Ultrasonic-accelerated metallurgical reaction of Sn/Ni composite solder:principle, kinetics microstructure, and joint properties,
Ultrason. Sonochem. 66 (2020)
https://doi.org/10.1016/j.ultsonch.2020.105090
[CROSSREF] [PMC] 47. J. W. Yoon, Y. S. Kim, and S .E. Jeong, Nickel-tin transient liquid phase sintering with high bonding strength for high-temperature power applications,
J. Mater. Sci. Mater. Electron. 30(22) (2019) 20205‚Äď20212.
https://doi.org/10.1007/s10854-019-02404-8
[CROSSREF] 49. D. Amiri, S. A. Sajjadi, R. Bakhtiari, and A. KamyabiGol, The role of TLP process variables in improvement of microstructure and mechanical properties in TLP joints of GTD-111/Ni-Cr-Fe-B-Si/GTD-111 system,
J. Manuf. Process. 32 (2018) 644‚Äď655.
https://doi.org/10.1016/j.jmapro.2018.03.036
[CROSSREF] 50. D. H. Jung, A. Sharma, M. Mayer, and J. P. Jung, A review on recent advances in transient liquid phase (TLP) bonding for thermoelectric power module,
Rev. Adv. Mater. Sci. 53(2) (2018) 147‚Äď160.
https://doi.org/10.1515/rams-2018-0011
[CROSSREF] 51. X. Peng, Y. Wang, Z. Ye, J. Huang, J. Yang, S. Chen, and X. Zhao, Microstructural evolution and performance of high-tin-content Cu40Sn60 (wt.%) core/shell powder TLPS bonding joints,
J. Manuf. Process. 75 (2022) 853‚Äď862.
https://doi.org/10.1016/j.jmapro.2022.01.045
[CROSSREF] 52. K. D. Min, C. J. Lee, B. U. Hwang, J. H. Kim, J. H. Jang, and S. B. Jung, Hybrid transient liquid phase sintering bonding of Sn-3.0 Ag-0.5 Cu solder with added Cu and Ni for CuNi bonding,
Appl. Surf. Sci. 551 (2021) 149396
https://doi.org/10.1016/j.apsusc.2021.149396
[CROSSREF] 53. S. E. Jeong, S. B. Jung, and J. W. Yoon, Fast formation of Ni-Sn intermetallic joints using Ni-Sn paste for high-temperature bonding applications,
J. Mater. Sci. Mater. Electron. 31(18) (2020) 15048‚Äď15060.
https://doi.org/10.1007/s10854-020-04068-1
[CROSSREF]

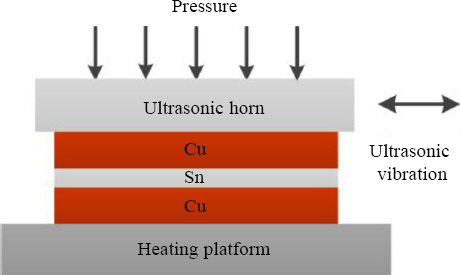

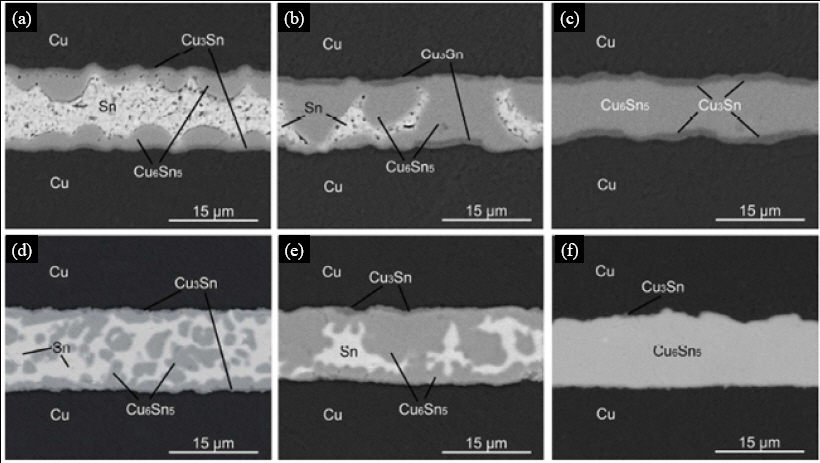





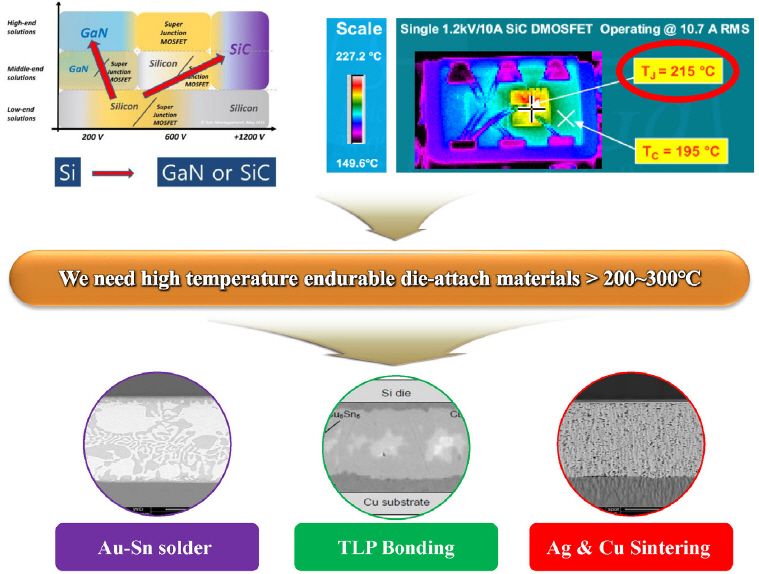
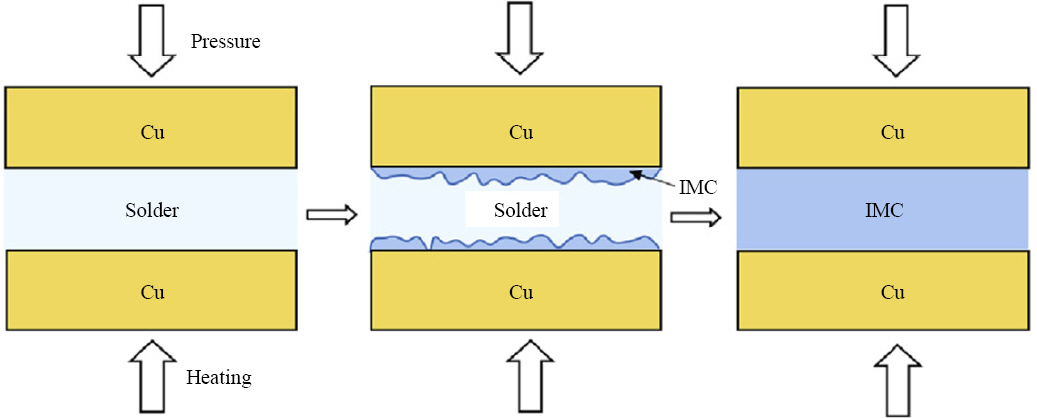




 PDF Links
PDF Links PubReader
PubReader ePub Link
ePub Link Full text via DOI
Full text via DOI Download Citation
Download Citation Print
Print



